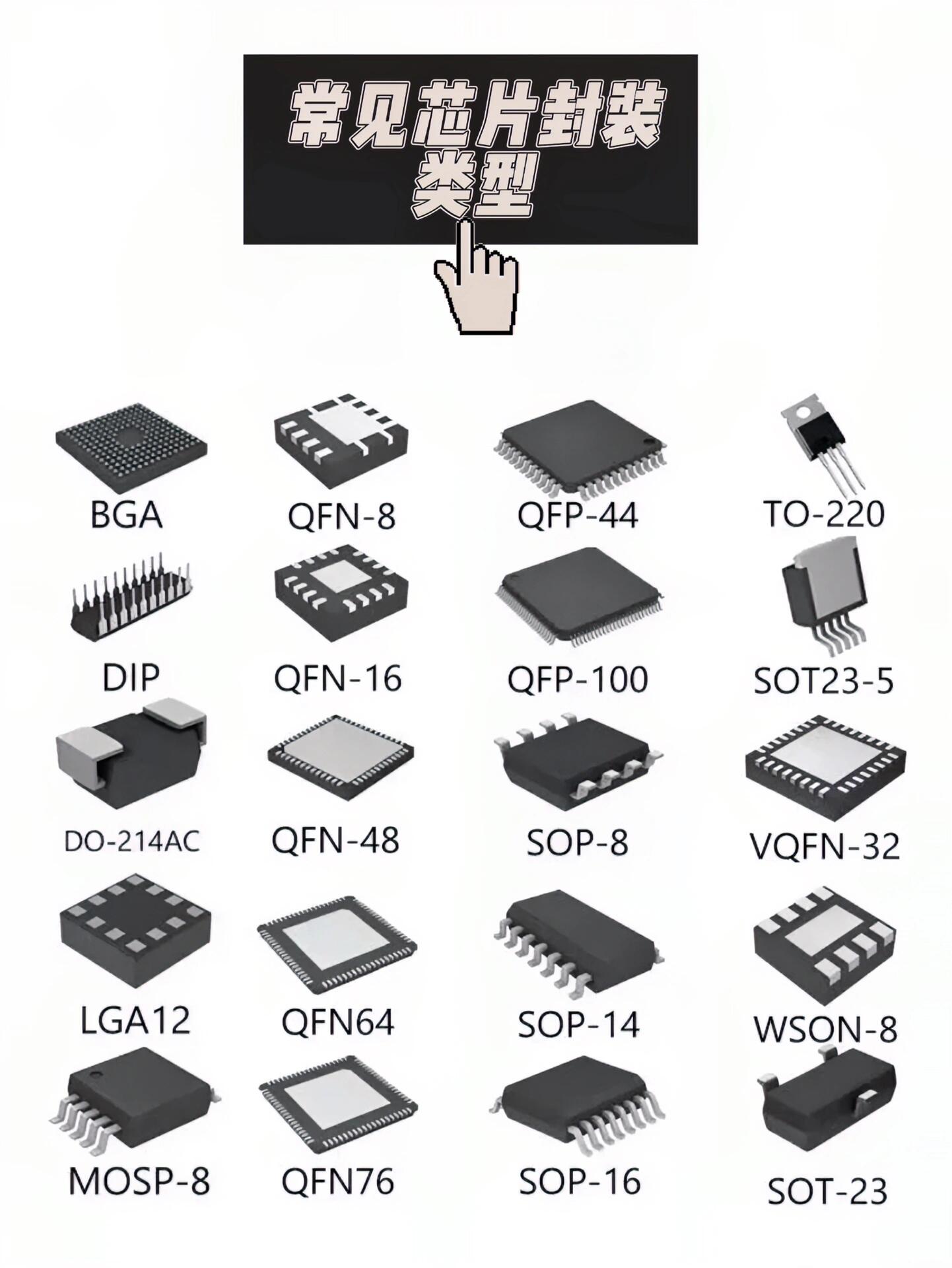
根据观研报告网发布的《中国半导体材料行业发展趋势研究与投资前景分析报告(2026-2033年)》显示,半导体材料主要分为晶圆制造材料和封装材料,其中晶圆制造材料包括硅片、掩模版、光刻胶、光刻胶配套试剂、工艺化学品、电子气体、CMP 抛光材料、靶材及其他材料,封装材料包括引线框架、封装基板、键合丝、包封材料、芯片粘结材料及其他封装材料。
受益于整体半导体市场的复苏以及高性能计算、高带宽存储器制造对先进材料需求的不断增长,2024年全球半导体材料销售额达675 亿美元,同比增长3.8%。从材料大类来看,2024年全球晶圆制造材料和封装材料销售额分别为 429 亿美元、246 j6股份有限公司亿美元,同比增长3.3%、 4.7%,占全球半导体材料销售额的比重为64%、36%。
从地区分布看,中国为核心市场,其中中国大陆半导体材料销售额达135亿美元,仅次于中国台湾,位居全球第二,占全球半导体材料销售额的比重约 20%。
晶圆制造材料中,硅片占比最大,达35%。尽管目前主要半导体硅片企业均已启动扩产计划,但其预计产能长期来看仍无法完全满足芯片制造企业对半导体硅片的增量需求,叠加中长期供应安全保障考虑,国内半导体硅片行业仍将处于快速发展阶段。根据数据,2019-2025年我国半导体硅片市场规模由77.1亿元增长至146.0亿元,期间CAGR达11.2%。
全球硅片市场呈现信越化学、胜高 SUMCO 主导的双寡头格局,二者凭借深厚技术积淀构筑高壁垒,高端产品优势显著。伴随先进制程持续扩产,12英寸大硅片需求稳步抬升,行业迎来明确国产替代窗口期:西安奕材 12 英寸硅片产能与出货量稳居大陆前列,已顺利切入海外头部供应链,国际化竞争力持续凸显;沪硅产业作为本土12英寸大硅片核心龙头,实现 14nm 级硅片量产落地,推动国内硅片产业完成向先进制程的关键跨越。
光刻胶、电子气体、靶材等关键材料技术壁垒高,日本信越化学、美国陶氏化学等海外企业主导高端市场,国内沪硅产业、安集科技等在部分品类实现替代突破,晶圆制造材料国产化进程进一步推进。
封装材料中,封装基板、引线框架、包封材料、键合丝四大核心材料构成行业绝对主体。封装基板为第一大细分品类,占比48.00%,其作为芯片与 PCB 板的互连载体,是先进封装核心材料,广泛用于 CPU/GPU、AI 芯片、HBM 存储等高端场景;包封材料(环氧塑封料 / EMC)占比22.00%,全球 90% 以上芯片采用环氧塑封料保护,具备绝缘、耐热、防潮、机械防护等核心功能;引线%,以铜合金为主,是传统封装(QFP/SOP/QFN)的电路连接与散热载体,70% 需求来自汽车电子、工业半导体;键合丝占比10.00%,主流为金线、铜线、银线及合金线,实现芯片与引线框架 / 基板的电气连接。
后摩尔时代,芯片性能提升从“制程缩微”转向“封装集成”,先进封装成为行业主线,倒逼材料向高密度、低介电、高导热、低应力、超薄化升级:
当前国内半导体封装材料企业集中于中低端领域,高端市场竞争力仍待提升。在中低端封装材料领域,国内企业凭借成本、本土化服务优势及下游封测龙头配套支持,已实现规模化布局,中低端环氧塑封料、普通铜引线框架、常规键合丝等产品国产化率超 50%,部分品类达 70% 以上,可满足传统封装场景需求,形成成熟产业集群,但企业多以模仿改进为主,研发投入有限,核心技术集中于生产工艺优化,产品同质化严重、盈利空间狭窄。
高端封装材料市场则被外资企业垄断。日本信越化学、住友电木、味之素,美国杜邦、汉高,欧洲巴斯夫、贺利氏等国际巨头凭借长期技术积淀、完善专利布局及稳定供应链,占据全球 80% 以上高端市场份额。高端封装材料需适配先进封装技术,对性能、精度要求极高,而国内企业在高端基板、低应力封装、高纯度原料等核心技术上仍有差距,关键原材料依赖进口,且面临客户认证周期长、专利壁垒高的困境。
此外,本土企业研发投入、人才储备远不及国际巨头,研发占比不足 5%,远低于国际头部企业的 10%-15%,专利布局薄弱,进一步制约了高端市场突破。总体来看,国内封装材料企业已在中低端领域实现自主可控,但高端领域仍有较大提升空间,需通过加大研发、完善供应链、突破核心技术,实现从 “规模优势” 向 “技术优势” 的转型。
Copyright © 2014-2026 j6国际科技有限公司 版权所有 陕ICP备2021015203号-1 j6国际官方网站