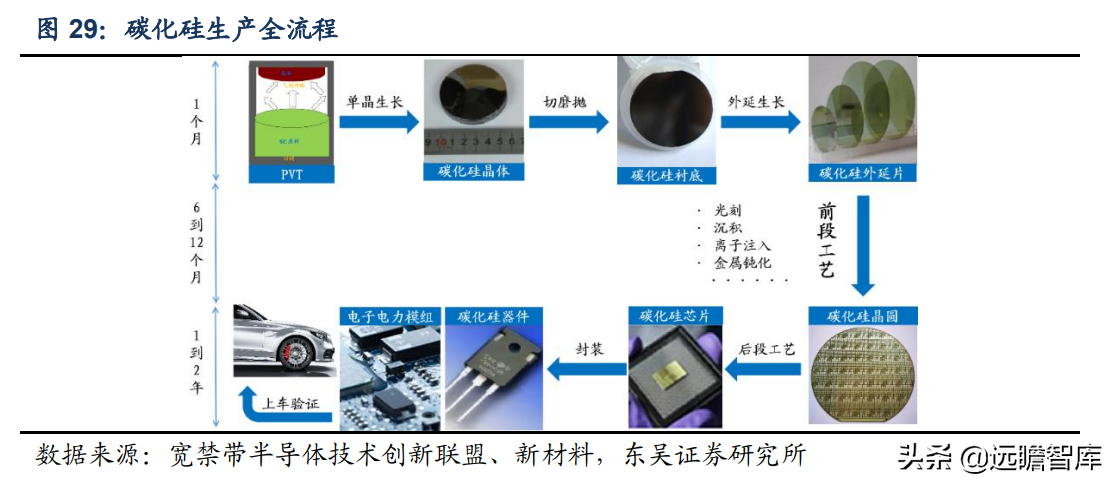
第4章 微电路与多芯片模块的材料与工艺 4.1混合电路用陶瓷基板 基板是一个电路的基础,起着元器件安装平台的作用,必须与基板金属化工艺以及元器件与金属化布线附接工艺兼容。 基板的性能要求: 高电阻率。基板必须具有很高的电阻率隔离相邻的电路; 高热导率。使正常工作的电子元器件产生的热传导出去; 耐高温。基板金属化和元器件组装在高温下进行; 耐化学腐蚀。抵抗熔剂、焊剂的侵蚀; 成本。成本与最终产品成本相适应。 第4章 微电路与多芯片模块的材料与工艺 4.1混合电路用陶瓷基板 陶瓷本质是带有非常少自由电子的晶体,具有很高的电阻,热学和化学性能稳定,并具有很高的熔点,非常适用很多微电子系统。 陶瓷常与金属结合在一起形成复合材料用于热管理。金属陶瓷(cermet)复合材料具有低的热膨胀系数和比陶瓷更高的热导率,韧性更好,更抗应力。 第4章 微电路与多芯片模块的材料与工艺 4.2 陶瓷的热性能 熔点 SiC: 2700℃; BeO:2570 ℃; BN:2732 ℃; Al2O3:2000; AlN:2232 ℃ 第4章 微电路与多芯片模块的材料与工艺 4.2陶瓷的热性能 热导率——材料载热能力的度量 q=-k·dT/dx k—热导率 W/(m·K); q—热流量 W/m2;dT/dx—稳态温度梯度; 比热容——每克物质每升高1K所需要的热量 c=dQ/dT 第4章 微电路与多芯片模块的材料与工艺 4.2陶瓷的热性能 热膨胀系数(TCE)——温度增加原子间距部对称引起的。金属和陶瓷在有意义的范围内显示一种线性的各向同性关系。 α=[L(T2)-L(T1)] / [L(T1)(T2-T1)] ppm/K-1 第4章 微电路与多芯片模块的材料与工艺 4.3 陶瓷基板的力学性能 第4章 微电路与多芯片模块的材料与工艺 4.3 陶瓷基板的力学性能 硬度——努氏(Knoop)硬度 金刚石:HK7000; BeO:HK1200; Al2O3:HK2100; BN:HK5000; AlN:HK1200; SiC:HK2500 第4章 微电路与多芯片模块的材料与工艺 4.3 陶瓷基板的电学性能 电阻率(倒数——电导率) 陶瓷基板电导率很低,由于存在杂质和晶体缺陷不同,电导率的变化很大; 击穿电压——陶瓷在正常情况下是好的绝缘体,但是在施加高的电位时,可产生足够的能量将电子从轨道中激发出去,同时又把其他电子从轨道中激发,产生雪崩效应,陶瓷的绝缘性被破坏,电流可以流动。 局部功率耗散或环境温度高,陶瓷表面润湿的高湿度条件下,伴有表面污染时,击穿电压比本征值低很多。 第4章 微电路与多芯片模块的材料与工艺 4.4 典型陶瓷基板材料 氧化铝 目前电子工业最常用的基板材料,在力、热、电性能上具有综合性能好的特点。原料丰富,价格低,适合用于不同形状。 密排六方刚玉结构,在1925℃还原气氛中稳定。 高温共烧陶瓷用W,Mo/Mn作为导体在1600 ℃烧结层压; 低温共烧陶瓷用Au,Pa/Ag作为导体在850 ℃烧结层压; 第4章 微电路与多芯片模块的材料与工艺 4.4 典型陶瓷基板材料 氧化铍 具有极高的热导率,比金属铝还高,热导率在300 ℃以上迅速降低,适用较低温度热沉; 密排立方闪锌矿结构,在干燥气氛2050℃稳定。在1100 ℃水解,在高温下和石墨反应生成碳化铍; BeO通过键合铜的工艺实现金属化。 可以加工成任何形状,但粉尘有毒。 第4章 微电路与多芯片模块的材料与工艺 4.4 典型陶瓷基板材料 氮化铝 把AlN粉末合助烧剂CaO,Y2O3以及有机粘接剂混合,流延成需要的形状,然后致密化烧结,必须在干燥的还原气氛下烧结。 高的热导率,并且与硅的TCE匹配 采用铜金属化工艺。 第4章 微电路与多芯片模块的材料与工艺 4.4 典型陶瓷基板材料 金刚石 采用化学气相沉积(CVD)生长。直接作为涂层沉积在难熔金属、氧化物、氮化物上,具有非常高的热导率,主要用于功率器件的封装。但其比热容较低,作为散热片与热沉材料一起工作效果较好。 第4章 微电路与多芯片模块的材料与工艺 4.4 典型陶瓷基板材料 氮化硼 具有明显的各向异性,在热压的BN法线方向热导率很高,TCE很低,可作为基板材料使用。 目前无法实现金属化。 第4章 微电路与多芯片模块的材料与工艺 4.4 典型陶瓷基板材料 碳化硅 可以采用热压、干压、等静压、CVD、流延法制备基片材料。 属于半导体,具有极高的热导率合很低的TCE,与硅的匹配好,比BeO合AlN便宜。 第4章 微电路与多芯片模块的材料与工艺 4.4 典型陶瓷基板材料 复合材料 将高的热导率合低的TCE结合在一起的主要是MMC。 Al/SiC:SiC体积比为70%~73%,TCE:6.5×10-6K,与AlO和BeO相当。 可以镀镍或镀金。 密度低。 可以制造功率器件和电路的热沉材料。 第4章 微电路与多芯片模块的材料与工艺 4.4 典型陶瓷基板材料 复合材料 Dymalloy合金:由金刚石和Cu20/Ag80合金构成的复合材料。6~50μm金刚石粉末在线%。 密度:6.4 g/cm3; 热导率:360 W/(m·K); TCE:5.48~6.5 ppm/K-1 抗拉强度:400MPa 第4章 微电路与多芯片模块的材料与工艺 4.5 厚膜技术 定义:混合电路用丝网印刷方法把导体浆料、电阻浆料和绝缘浆料转移到一个陶瓷基板上来制造。印刷的膜经过烘干去除挥发性成分,然后再较高温度下活化粘接机构,完成膜与基板的粘接。 第一层导体 带有互联孔的介质层 第二层导体 第4章 微电路与多芯片模块的材料与工艺 4.6 厚膜导体材料 金导体 最常用于高可靠性场合:军事和医用; 金会和锡产生合金化熔入含锡的钎料中;引线的铝也会扩散到金中,必须避免; 银导体 商用;银会溶于Pb/Sn焊料中; 铜导体 替代金,但问题很多; 第4章 微电路与多芯片模块的材料与工艺 4.7 厚膜电阻材料 厚膜电阻:将金属氧化物和玻璃颗粒混合,在高温下烧结,使玻璃熔化而将氧化物颗粒烧结在一起。金属氧化物与玻璃的比越高,烧成的膜的电阻率越低。 4.8 厚膜介质材料 以简单的交叠结构或复杂多层结构用作导体间的绝缘体。 第4章 微电路与多芯片模块的材料与工艺 4.9 薄膜技术 薄膜技术是一种减法技术,整个基板用几种金属化沉淀,再用一系列光刻工艺把不需要的材料蚀刻掉。 基板 电阻NiCr,TaO 阻挡层Cr,TiW 导体Au 第4章 微电路与多芯片模块的材料与工艺 4.10 沉积技术 溅射 蒸发 电镀 光刻 第2章 金属 2.3 金属和合金产品的性能 2.3.4 性能比较 比强度 第2章 金属 2.3 金属和合金产品的性能 2.3.4 性能比较 热导率:Ag/Cu/Au/Al具有高热导率,合金化会降低热导率。 第2章 金属 2.4 铁基合金 2.4.1 铁基合金概述 铁元素含量大于或等于50%的合金被称为铁基合金。也包含铁含量低于50%但其性能要求和铁系合金很相似的合金。 分类: 结构用钢 碳素钢 合金钢 高强度 低合金钢 超高强钢 轧制 热处理钢 特殊用钢 第2章 金属 2.4 铁基合金 2.4.2 常用铁基合金 碳素钢和合金钢 1xxx属于C为主要合金元素的钢; 2xxx属于Ni为主要合金元素的钢; 不锈钢和特殊钢 含有至少11%左右Cr的铁基合金; 磁钢 高磁导率合金、永磁合金、不锈钢、温度补偿合金 第2章 金属 2.4 铁基合金 2.4.3 铁基合金磁学性能 高磁导率合金(软磁合金)在合金内磁流密度变化引起的磁滞损失小,在强磁场作用后剩磁低,在高度磁化后并不保留明显的永久性磁性。 Ni-Fe合金(30%~80%Ni,其余Fe) 80Ni-4Mo-Fe合金、77Ni-1.5Cr-5Cu-Fe合金、49Ni-Fe合金 硅铁合金(硅钢片) 钴铁合金 永磁合金(硬磁材料) 温度补偿合金 第2章 金属 2.4 铁基合金 2.4.4 铁基合金热膨胀性能 合金的热膨胀性能一般用材料的温度变化引起单位长度的变化来表示; Invar合金(36Ni-Fe)是所有金属(合金)中热膨胀系数最小的。 玻璃—金属封接合金:金属和玻璃之间的线 铁基合金加工性能 深拉 焊接 光化学加工 陶瓷—金属封接合金 弹性合金的不变模量 第2章 金属 2.4 铁基合金 2.4.6 铁基合金电阻性能 大多数合金的电阻率是随温度的升高而增大的。 第2章 金属 2.5 铝和铝合金 2.5.1 铝合金的一般性能 铝的电学性能(纯铜的62%); 铝的热导率高; 铝的密度小; 铝的比强度高; 铝的耐蚀性高; 铝的可获得性; 铝的机加工; 铝的连接。 第2章 金属 2.5 铝和铝合金 2.5.2 铝合金 砂模铸造、压铸、熔模铸造、金属型铸造、石膏模铸造 电子封装中使用的铸造铝合金 通用铝合金 A356; 可钎焊铝合金 A612; 低热膨胀铝合金 高Si(18%~20%); 高强度铝合金A220。 第2章 金属 2.6 铍和铍合金 2.6.1 铍合金的一般性能 铍具有综合的物理和力学性能,可作为满足热性能和电性能要求的电子封装材料。 铍具有高的热导率,高的热容,是天然的轻质热沉材料。 Be, BeO ; AlBeMet—铍铝合金(62%Be) 铍易被氯化物腐蚀,可采用阳极氧化涂层提高耐蚀性。 毒性—BeO粉尘对身体有害 Be的耐磨性好,工具磨损厉害。 第2章 金属 2.7 铜和铜合金 2.7.1 铜合金的一般性能 除银之外,铜具有最高的电导率; 铜的成形性非常好,制造性好; 铜的可焊性好; 铜的表面可进行电镀精饰; 铜可以加工成各种大小和形状的产品; 铜的热导率高,可以作为热沉材料使用; 铜和铜合金成本相对较低; 第2章 金属 2.7 铜和铜合金 2.7.2 高导电率铜合金 工业纯铜——退火状态下,100%IACS(国际退火铜标准) 370℃产生氢脆,金属内的氧与氢气结合,不适合于钎焊场合,P脱氧Cu可制备无氧铜。 含银铜——铜中加入少量银的高导铜。100%电导率,具有耐蠕变能力和高温抗软化能力,可在343℃进行充分退火。 铜锆合金——0.15%Zr,改善高温性能,稍微降低电导率; 铜碲合金——90%IACS,力学性能大幅度提高; 铜硫合金——96%IACS,力学性能大幅度提高。 第2章 金属 2.7 铜和铜合金 2.7.3 黄铜(Cu-Zn合金) 随锌含量增加(30%),抗拉强度增加; 随锌含量增加,电导率增加,热导率降低; 随锌含量增加,韧性增加; 加入铅改善机加工性能,0.5%~4.5%。 第2章 金属 2.7 铜和铜合金 2.7.4 磷青铜(Cu-1%~11%Sn-0.04%~0.35%P合金) 弹簧用 2.7.5 铍铜 综合高强度和高电导率(1380MPa) 第2章 金属 2.8 镁和镁合金 是目前可用的金属结构材料中密度最小的。 可获得铸件、片材、板材、棒材、锻件、型材。 镁合金铸件 镁合金成形——难成形著称 连接——铆接、熔焊、硬钎焊 第2章 金属 2.9 镍和镍合金 高强度、高耐蚀性和高韧性 电导率高 磁致伸缩性能 Ni-Cu (Monel合金)——弹簧材料使用 各种形式(薄片到细丝) 加工性好——加工、连接、硬钎焊 合金化具备不同磁性能和电性能 不同力学性能 第2章 金属 2.10 钛和钛合金 极好的耐蚀性,适中的密度和良好的强度; 可在315℃下使用,超过其它金属; 电导率和热导率低; αTi(HCP)、βTi(BCC)、α+βTi型钛合金。 高的力学性能(室温1034MPa) 耐蚀性使用在化工领域 加工形式——片材、板材、棒材、锻件、型材 连接——钨基惰性气体保护电弧焊 第2章 金属 2.11 高密度金属 铅、钨、贫化铀 铅和铅合金(11.35)——配重首选材料 烧结钨(17) 贫化铀(18.5) 第2章 金属 2.12 难熔金属 钨、钼、钽、铌 极好的耐酸性 1000℃高温下使用 钨、钼热膨胀率低,可以与玻璃和陶瓷一起使用 第2章 金属 2.13 贵金属 相当普遍的使用的电子设备上,用作表面材料 抗干扰电学性能和光学性能,使用金、铑、铂 银是金属中电导率和热导率最高的金属,作为各种引线和电触电上的镀层; 金用来防止腐蚀,并提供低的电接触表面; 铑具有很高的反射率,低的表面电阻、高的硬度和耐腐蚀性,适合作为电接触表面和反射镜面。 第3章 软钎焊材料和技术 3.1 电子封装和组装简介 钎料是所有三极连接(芯片、封装和板级组装)和互连材料。 锡/铅钎料作为表面涂层用于元器件引线和表面镀层。 实现金属表面的电、热和机械连接 表面组装技术可开发更高级的电路板组件,在金属化的基板上将片式电阻、电容和半导体裸芯片互连,所有的元件和器件放置在印刷电路板表面上进行板级组装而不是插入电路板。 第3章 软钎焊材料和技术 3.1 电子封装和组装简介 表面组装的优点: 提高了电路密度; 缩小了元器件的尺寸; 缩小了电路板的尺寸; 减轻了质量; 缩短了引线; 改善了电性能; 适应自动化生产; 降低了大规模生产的成本 第3章 软钎焊材料和技术 3.2 软钎料合金 液相线℃的可熔融合金。 软钎料合金常用的元素:锡、铅、银、铋、铟、锑、镉 Sn Pb Ag Bi In Sb Cd 232 328 961 271.5 156.6 630.5 321.2 软钎料合金可提供的形式: 棒、锭、丝、粉末、成形片、焊球、焊柱、焊膏 选择原则 合金熔化温度、合金力学性能、冶金相容性、环境相容性、特定基板上润湿能力、成分共晶还是非共晶 第3章 软钎焊材料和技术 3.2 软钎料合金 Sn-Pb钎料合金成分和熔化范围 70Sn/30Pb 183℃-193℃ 63Sn/37Pb 183℃-183℃等共28种 软钎料粉——化学还原法、电解沉积法、固体颗粒机械加工法、液相合金雾化法 力学性能——应力/应变行为、抗蠕变性能、抗疲劳性能 软钎料在电子封装中经历低周疲劳(低于10000次) 第3章 软钎焊材料和技术 3.3 焊膏 由钎料合金粉末、钎剂和载体的均匀、动态稳定的混合物,在一系列软钎焊条件下形成冶金结合并适应自动化生产得到可靠和一致性的焊点。 钎剂用来清洁合金粉末和待焊基底,来得到高可靠的金属连续性和形成良好的润湿性; 载体是承载合金粉末,获得需要的流变性 物理形貌、稳定性和保存期、黏度、冷塌度、通过细针头的可滴涂性、粘附时间、曝露寿命、质量和一致性、与待焊表面相容性、熔融前的流动性、润湿性、焊珠、毛细现象、残留物的可清洁性、焊点外观、焊点孔洞 第3章 软钎焊材料和技术 3.4 钎剂和助焊 确保待焊表面的“清洁”必须在软钎焊过程中一直保持,这种清洁过程称为助焊,使用的材料称为钎剂或助焊剂。 松香基钎剂、水溶性钎剂和免清洗钎剂 钎剂可以配入焊膏或焊丝中,也可以作为独立的化学物质直接施加在元件和焊膏上。 第3章 软钎焊材料和技术 3.5 软钎焊方法 工业使用的方法: 传导、红外、汽相、热气体、对流、感应、电阻、激光等。 局部加热:激光; 温度均匀:汽相; 品种、产量和经济性:对流、红外 混合电路组件:传导 第3章 软钎焊材料和技术 3.6 无铅钎料 美国立法对铅钎料进行限制,低于0.1%; 日本2003年完全停止使用无铅钎料; 欧洲RoHS指令禁止使用铅、汞、镉、六价铬 设计原则: 以Sn为基础,合金元素有与Sn形成合金的能力; 与Sn合金化时,降低合金熔点 第3章 软钎焊材料和技术 3.6 无铅钎料 合金体系的选择: Sn/Ag/Bi Sn/Ag/Cu Sn/Ag/Cu/Bi Sn/Ag/Bi/In Sn/Ag/Cu/In Sn/Cu/In/Ga 第3章 软钎焊材料和技术 3.6 无铅钎料 合金成分的选择 Sn-3.0~3.5Ag/0.5~1.5Cu/4.0~8.0In Sn-3.0~3.5Ag/1.0~3.0Bi/0.5~0.7Cu Sn-3.3~3.5Ag/1.0~3.0Bi/1.7~4.0In Sn-0.5~0.7Cu/5.0~6.0In/0.4~0.6Ga Sn-3.0~3.5Ag/0.5~1.5Cu Sn-3.0~3.5Ag/1.0~4.8Bi 99.3Sn/0.7Cu 96.5Sn/3.5Ag 第4章 微电路与多芯片模块的材料与工艺 混合微电子电路的基础是由某种耐熔陶瓷制造的基板。 在基板上,通过膜技术制作金属化图形形成安装焊盘和电路布线,并用来键合和互连必要的有源器件和无源器件。 多芯片模块采用了更广泛的基板材料和金属化工艺,从而得到更高的封装密度。 聚合物 金属陶瓷 溅射 蒸发 钎焊 电镀铜 膜淀积技术 厚膜 薄膜 纯铜 多芯片模块 厚膜 薄膜 PC板 电子封装材料与工艺 Electronic Packaging Materials Technology 余琨 中南大学 材料科学与工程学院 2011 References: 1. C.A. 哈珀[美]主编, 贾松良等译, 电子组装制造, 科学出版社, 北京, 2004 2. 宣大荣编著, 无铅焊接?微焊接技术分析与工艺设计, 电子工业出版社, 北京, 2008 3. 刘汉诚[美]著, 冯士维等译, 化学工业出版社, 北京, 2006 第1章 集成电路芯片的发展和制造 1.1 真空管(电子管) 是由一个带有电极引线的玻璃或金属泡组成,电极引线通过玻璃引出并与模铸在一个塑料管座内的金属管脚相连接。 当电子管含有2个电极(阴极和阳极)时,这种电路称为二极管。 在阴极和阳极间加入一个栅极(精细的金属丝网),控制电子从阴极到金属板(阳极)的流动方法,对电子从阴极向阳极流向产生巨大影响。在三电极的情况下可以使用一个真空管整流和放大微弱的无线信号,称为三极管。 第1章 集成电路芯片的发展和制造 1.2 半导体材料 半导体具有完全不同于金属的物理特性。半导体是共价的固体。 最重要的半导体材料是周期表ⅣA族的硅和锗。 两种或两种以上的元素形成共价键可以形成半导体化合物,如镓和砷结合成的砷化镓。 在IC芯片制造中使用的典型半导体材料: 硅、锗、硒 GaAs、GaAsP、InP 第1章 集成电路芯片的发展和制造 1.2 半导体材料 Ge是制造第一个晶体管和固态器件的元素半导体,但难加工,目前使用少; Si是最常用的半导体材料,90%的芯片由它制造。硅储量丰富且在高温下仍能保持良好的电性能。SiO2也具有IC制造的理想性能; GaAs可工作在较高工作频率,具有低热耗散、耐辐射、相邻元件之间漏电少,属于高性能用途半导体,但晶体生长和IC制造困难; 第1章 集成电路芯片的发展和制造 1.3 集成电路(IC) 一个集成电路芯片是把元器件连在一起的集合体,在一个单片半导体材料上制造出一个完整的电子电路; 第一块IC的构思和建造为1958年Texas Instruments 公司的Jack Kilby。将晶体管、二极管、电阻、电容等用“飞线年Fairchild 公司的Robert Noyce 将IC半导体元件在芯片内互连,消除了“飞线”。 IC的复杂程度从1960年代的小规模集成(SSI)发展到中规模集成(MSI)、大规模集成(LSI)并发展到105元件的超大规模集成(VLSI)。 第1章 集成电路芯片的发展和制造 1.3 集成电路(IC) IC的五个主要用途: 汽车 高性能产品 高性价比产品 手提式产品 存储器 第1章 集成电路芯片的发展和制造 1.4 集成电路(IC)芯片的制造 硅是使用最多的IC制造材料 第1章 集成电路芯片的发展和制造 1.4 集成电路(IC)芯片的制造 1.4.1 晶体生长和晶圆片的制备 晶圆片是构成IC的半导体衬底。 精炼粗硅(制备化学纯多晶硅→加热到1415℃熔化→生长单晶硅→切割晶圆片) 晶圆片厚度为0.5mm到0.75mm,采用0.152mm厚的金刚石涂层的不锈钢刀片。 在410mm的晶锭上用0.17mm的线锯一次切出所有晶圆片,采用黄铜涂层的不锈钢丝。 晶圆片进行镜面光洁度研磨。 第1章 集成电路芯片的发展和制造 1.4 集成电路(IC)芯片的制造 1.4.1 晶体生长和晶圆片的制备 第1章 集成电路芯片的发展和制造 1.4 集成电路(IC)芯片的制造 1.4.2 氧化 在晶圆片上形成SiO2层。 SiO2是用来构造IC 元件电容和MOS晶体管的有效介质。 1200 ℃氧气中生长0.2μm厚度的SiO2层需要6min;生长0.4 μm厚度需要220min。 影响因素:干燥的氧或氧与水蒸气的混合气体、压力、温度、晶体取向、时间 第1章 集成电路芯片的发展和制造 1.4 集成电路(IC)芯片的制造 1.4.3 光刻 是一种图形化工艺,组成IC电路的元件通过光掩模和刻蚀转移到晶圆片上。类似照相过程,在玻璃的制成的光刻版上形成各种半导体层的图形,然后转移到硅晶圆片表面的光刻胶上。 第1章 集成电路芯片的发展和制造 1.4 集成电路(IC)芯片的制造 1.4.4 扩散 扩散或掺杂是把杂质原子注入纯硅的单晶内,使其转变成n-型或p-型半导体。 掺入锑、砷、磷得到n-型半导体; 掺入硼得到p-型半导体; 第1章 集成电路芯片的发展和制造 1.4 集成电路(IC)芯片的制造 1.4.5 外延 把一个薄层的硅(厚度约25 μm)沉积在原来的硅表面上,并使用扩散工艺中同样的掺杂剂进行掺杂,也属于p-n结制造技术。主要采用CVD技术。 常压CVD (APCVD); 低压CVD(LPCVD); 等离子体增强CVD(PECVD). 第1章 集成电路芯片的发展和制造 1.4 集成电路(IC)芯片的制造 1.4.6 金属化 在芯片表面上电路元器件部件与键合焊盘之间沉积导电材料,形成互连引线,称为金属化工艺。 铝、铝合金、铂、钛、钨、钼、金可用于金属化工艺。 铝是最常用的金属化材料,与Si和SiO2可以很好的粘附(低接触电阻),容易真空沉积(沸点低),导电率高,容易通过光刻工艺布图。 真空沉积和溅射是沉积铝金属化层的方法。 问题:Al-Si共晶合金。解决办法:TiW阻挡层;将1%的Si加入Al中。 第1章 集成电路芯片的发展和制造 1.4 集成电路(IC)芯片的制造 1.4.7 钝化 在芯片金属化后,为防止铝互连电路受到水汽和污染的侵蚀,通过气相沉积在芯片电路上形成二氧化硅或氮化硅绝缘层或钝化层。 第1章 集成电路芯片的发展和制造 1.4 集成电路(IC)芯片的制造 1.4.8 背面研磨 覆盖钝化层后,芯片需要减薄满足封装高度要求,晶圆片进行背面研磨 第1章 集成电路芯片的发展和制造 1.4 集成电路(IC)芯片的制造 1.4.9 背面金属化 芯片背面要有一层金膜,通过真空蒸发或溅射沉积,使芯片背面与芯片粘接区电接触。 第1章 集成电路芯片的发展和制造 1.4 集成电路(IC)芯片的制造 1.4.10 电性能测试 按照预先确定的规范对芯片进行电性能测试。 第1章 集成电路芯片的发展和制造 1.4 集成电路(IC)芯片的制造 1.4.11 管芯分割 芯片采用两种方法分割 厚度小于0.25mm的芯片,采用金刚石刀具在晶圆片上划出细的切割线,再用剥离胶带使晶圆片断裂j6国际; 厚度大于0.25mm的芯片,采用剥离胶带和金刚石圆锯切割。 第1章 集成电路芯片的发展和制造 1.4 集成电路(IC)芯片的制造 1.4.12 p-n-p双极晶体管的典型结构 第2章 金属 2.1 金属和合金的选择 选择金属材料时,要针对电子电气工业中的要求进行权衡。 判据: 物理性能; 力学性能; 可制造性; 经济性; 第2章 金属 2.2 金属和合金产品的形式 铸造金属产品 加工金属产品 铸造金属形式是通过把熔融的金属浇入需要的形状的模具内形成,没有金属变形发生。金属的性能取决于: 铸造工艺(砂模铸造、熔模铸造、压铸); 铸件致密性; 化学成分; 热处理。 第2章 金属 2.2 金属和合金产品的形式 铸造金属产品的重要性能 致密度——孔隙度和非金属缺陷少; 力学性能; 晶粒尺寸——冷却速度快则晶粒尺寸小,强度大; 金属形状——薄壁小铸件比致密度相同的厚壁大铸件强度高; 铸型材料; 铸造技术和工艺——特殊铸造工艺的使用,如半固态金属加工技术、金属注射成形技术制造Al/SiC和W/Cu 第2章 金属 2.2 金属和合金产品的形式 压力加工金属产品的重要性能 加工的形式——轧制、挤压、拉拔、锻造 组织结构——晶粒尺寸、晶体取向、致密度、夹杂物尺寸形状、相 变形条件——温度(冷、热加工) 强化——加工硬化、沉淀强化、相变硬化 第2章 金属 2.3 金属和合金产品的性能 2.3.1 力学性能 常规力学性能——室温屈服强度、抗拉强度和延伸率 交变载荷(疲劳)——允许的应力远远低于材料的抗拉强度,金属将在低于屈服强度和极限抗拉强度的应力水平下失效。 持续载荷——长时间持续载荷导致低于屈服强度的蠕变和断裂发生,在高温下和室温下都有发生。 温度影响——强度随温度升高而降低。 第2章 金属 2.3 金属和合金产品的性能 2.3.2 物理性能 冷加工——导致电导率降低; 热处理——对合金元素和相结构及分布有不同影响 温度——物理性能随温度变化逐渐变化。 第2章 金属 2.3 金属和合金产品的性能 2.3.3 制造可行性 可成形性——深拉 可机械加工性 连接——螺栓连接、铆接、焊接、硬钎焊、软钎焊 可焊接性——焊接开裂、焊缝耐蚀性、焊接接头脆性 硬钎焊——考虑后续热处理 软钎焊 第2章 金属 2.3 金属和合金产品的性能 2.3.4 性能比较 屈服强度 零件可承受的 最大应力。 第2章 金属 2.3 金属和合金产品的性能 2.3.4 性能比较 弹性模量 表征了零件的刚度 比刚度——Ti/Mg/Al,铍的比刚度是常用结构材料的6~12倍。
2、成为VIP后,下载本文档将扣除1次下载权益。下载后,不支持退款、换文档。如有疑问请联系我们。
3、成为VIP后,您将拥有八大权益,权益包括:VIP文档下载权益、阅读免打扰、文档格式转换、高级专利检索、专属身份标志、高级客服、多端互通、版权登记。
4、VIP文档为合作方或网友上传,每下载1次, 网站将根据用户上传文档的质量评分、类型等,对文档贡献者给予高额补贴、流量扶持。如果你也想贡献VIP文档。上传文档
2026年全球制药业创新药物研发报告及未来五至十年医药健康报告.docx
《公职人员政务处分法》重点内容全面解读(含全文) PPT课件--.pptx
原创力文档创建于2008年,本站为文档C2C交易模式,即用户上传的文档直接分享给其他用户(可下载、阅读),本站只是中间服务平台,本站所有文档下载所得的收益归上传人所有。原创力文档是网络服务平台方,若您的权利被侵害,请发链接和相关诉求至 电线) ,上传者
Copyright © 2014-2026 j6国际科技有限公司 版权所有 陕ICP备2021015203号-1 j6国际官方网站