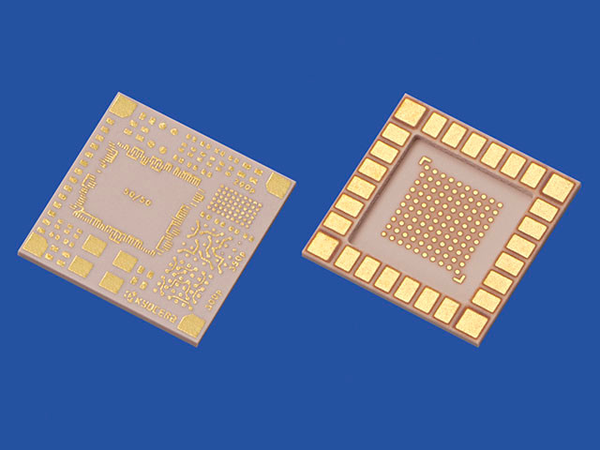
半导体材料作为半导体产业链上游的重要环节,在芯片的生产制造过程中起到关键性作用。根据芯片制造过程划分,半导体材料主要分为基体材料、制造材料和封装材料。其中,基体材料主要用来制造硅晶圆或化合物半导体;制造材料主要是将硅晶圆或化合物半导体加工成芯片所需的各类材料;封装材料则是将制得的芯片封装切割过程中所用到的材料。
您也可以直接登录淘宝网首页搜索“锦正茂科技”,可以看到我们的淘宝店铺,联系更加方便!
采用粘结技术实现管芯与底座或封装基板连接的材料,在物理化学性能上要满足机械强度高、化学性能稳定、导电导热、低固化温度和可操作性强的要求。在实际应用中主要的粘结技术包括银浆粘接技术、低熔点玻璃粘接技术、导电胶粘接技术、环氧树脂粘接技术、共晶焊技术。环氧树脂是应用比较广泛的粘结材料,芯片和封装基本材料表面呈现不同的亲水和疏水性,需对其表面进行等离子处理来改善环氧树脂在其表面的流动性,提高粘结效果。
用于承载电子元器件的机械支撑、环境密封和散热等功能。相比于金属封装材料和塑料封装材料,陶瓷封装材料具有耐湿性好,良好的线膨胀率和热导率,在电热机械等方面性能极其稳定,但加工成本高,具有较高的脆性。
您也可以直接登录淘宝网首页搜索“锦正茂科技”,可以看到我们的淘宝店铺,联系更加方便!
是封装材料中成本占比最大的部分,主要起到承载保护芯片与连接上层芯片和下层电路板的作用。完整的芯片是由裸芯片(晶圆片)与封装体(封装基板与固封材料、引线等)组合而成。封装基板能够保护、固定、支撑芯片,增强芯片的导热散热性能,另外还能够连通芯片与印刷电路板,实现电气和物理连接、功率分配、信号分配,以及沟通芯片内部与外部电路等功能。
您也可以直接登录淘宝网首页搜索“锦正茂科技”,可以看到我们的淘宝店铺,联系更加方便!
晶圆切割是半导体芯片制造过程中重要的工序,在晶圆制造中属于后道工序,主要将做好芯片的整片晶圆按照芯片大小切割成单一的芯片井粒。在封装流程中,切割是晶圆测试的前序工作,常见的芯片封装流程是先将整片晶圆切割为小晶粒然后再进行封装测试,而晶圆级封装技术是对整片晶圆进行封装测试后再切割得到单个成品芯片。
目前主流的切割方法分为两类,一类是用划片系统进行切割,另一类利用激光进行切割。其中划片系统切割主要包括砂浆切割和金刚石材料切割,该技术起步较早shi chang 份额较大。激光切割属于新兴无接触切割,切割表面光滑平整,适用于不同类型的晶圆切割。
凡本网注明“来源:化工仪器网”的所有作品,均为浙江兴旺宝明通网络有限公司-化工仪器网合法拥有版权或有权使用的作品,未经本网授权不得转载、摘编或利用其它方式使用上述作品。已经本网授权使用作品的,应在授权范围内使用,并注明“来源:化工仪器网”。违反上述声明者,本网将追究其相关法律责任。
本网转载并注明自其他来源(非化工仪器网)的作品,目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,不承担此类作品侵权行为的直接责任及连带责任。其他媒体、网站或个人从本网转载时,必须保留本网注明的作品第一来源,并自负版权等法律责任。
如涉及作品内容、版权等问题,请在作品发表之日起一周内与本网联系,否则视为放弃相关权利。
Copyright © 2014-2026 j6国际科技有限公司 版权所有 陕ICP备2021015203号-1 j6国际官方网站