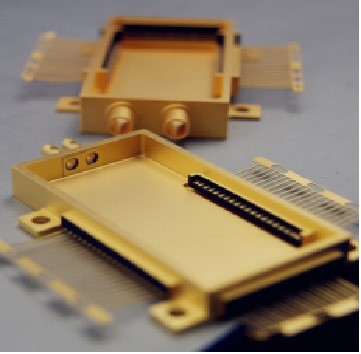
电子封装用材料电子封装材料典型应用电子封装材料是用于承载电子元器件及其互连线,并具有良好电绝缘性能的基本材料,主要起机械支持、密封保护、信号传递、散失电子元件所产生的热量等作用,是高功率集成电路的重要组成部分。因此对于封装材料的性能要求有以下几点:具有良好的化学稳定性,导热性能好,热膨胀系数小,有较好的机械强度,便于加工,价格低廉,便于自动化生产等。然而,由于封装场合的多样化以及其所使用场合的差异性,原始的单一封装材料已经不能满足日益发展的集成电路的需要,进而出现了许多新型的封装材料,其中一些典型材料的种类及应用场合列举如下。 1、金属金属材料早已开发成功并用于电子封装中,因其热导率和机械强度高、加工性能好,因此在封装行业得到了广泛的应用。表1为几种传统封装金属材料的一些基本特性。其中铝的热导率高、质量轻、价格低、易加工,是最常用的封装材料。但由于铝的线/K)和GaAs的线/K)相差较大,所以,器件工作时热循环所产生的较大热应力经常导致器件失效,铜材也存在类似的问题。Invar(镍铁合金)和Kovar(铁镍钴合金)系列合金具有非常低的线膨胀系数和良好的焊接性,但电阻很大,导热能力较差,只能作为小功率整流器的散热和连接材料。W和Mo具有与Si相近的线膨胀系数,且其导热性比Kovar合金好,故常用于半导体Si片的支撑材料。但由于W、Mo与Si的浸润性不好、可焊性差,常需要在表面镀上或涂覆特殊的Ag基合金或Ni,从而增加了工序,使材料可靠性变差,提高了成本,增加了污染。此外,W,Mo,Cu的密度较大,不宜作航空、航天材料;而且w,Mo价格昂贵,生产成本高,不适合大量使用。钨铜、钼铜合金电子封装中经常使用的材料,也称为热沉材料,钨铜合金既具有钨的低膨胀特性,又具有铜的高导热特性,其热膨胀系数和导热导电性能可以通过调整钨铜的成分而加以改变,因而给钨铜提供了更广的应用范围。由于钨铜材料具有很高的耐热性和良好的导热导电性,同时又与硅片、砷化镓及陶瓷材料相匹配的热膨胀系数,故在半导体材料中得到广泛的应用。用于封装热沉的钨铜材料的主要性能材料热导率热膨胀系数密度 W/(mk)ppm/Cg/cm3W90Cu10180~W85Cu15190~200W80Cu20200~W75Cu25220~ 钼铜材料的主要性能 W/(mk)ppm/Cg/cm3 Mo50Cu50230-270 Mo60CuMo70Cu CuMoCu1:1:1250 CuMoCu1:2:1210 CuMoCu1:3:1190 CuMoCu1:4:1180 CuMoCu13:74: 金属材料由于密度较大,但是却有很高的导热系数。因此适用于大功率器件的封装材料、热沉材料、散热元件、陶瓷以及砷化镓基座等。 2、陶瓷 SMD(表面贴装器件)陶瓷封装基座,广泛用于石英晶体振荡器和石英晶体谐振器的陶瓷封装基座。半导体陶瓷封装形式是一种比较特殊的封装形式,可以直接应用于大功率工作环境中。这种形式的封装优点是: 1)、耐湿性好,不易产生微裂现象; 2)、热冲击实验和温度循环实验后不产生损伤,机械强度高;3)、热膨胀系数小,热导率高; 4)、绝缘性和气密性好,芯片和电路不受周围环境影响,更重要的是其气密性能满足高密封的高要求; 5)、避
Copyright © 2014-2026 j6国际科技有限公司 版权所有 陕ICP备2021015203号-1 j6国际官方网站